Dünne Diffusionsbarrieren auf Ta-Basis
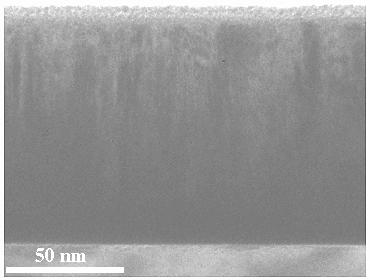 |
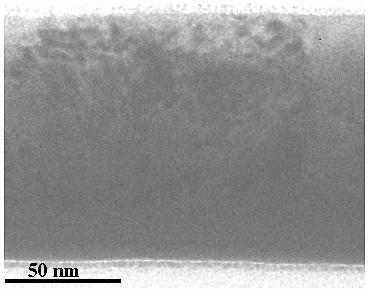 |
|
Abb.1: TEM Querschnittsaufnahmen, die die Zerstörung der säulenförmigen Struktur einer durch Sputtern abgeschiedenen 100 nm Ta-Schicht durch Implantation von 3x1017 N+/cm2 (65 keV) zeigen.
(a) nach der Abscheidung |
(b) nach der Implantation |
Bei der Weiterentwicklung der Metallisierungstechnologien für höchstintegrierte mikroelektronische Schaltkreise erfodert die Ablösung von Al durch Cu hocheffektive Diffusionsbarrieren. Ta ist dafür ein sehr vielversprechendes Material. Bei Barrierendicken unterhalb 50 nm kommt es jedoch zu Ausfällen, die durch Defekte wie Korngrenzen, Hohlräume u.a. bedingt sind.
Barriereschichten auf Ta-Basis wurden durch Ionenimplantation von Stickstoff und Sauerstoff modifiziert, um diffusionsfördernde Defekte durch Amorphisierung oder eine Gefügeumwandlung im Ergebnis der Bildung neuer Phasen zu reduzieren.
Stickstoffimplantation führt mit steigender Dosis zu Gitteraufweitung, dann zur Amorphisierung und schließlich zu Nitridbildung. Für Sauerstoffimplantation ist der Dosisbereich, in dem man Amorphisierung erreicht, wesentlich breiter. Abb. 1 zeigt die Zerstörung der bei der Abscheidung mittels Sputtern gebildeten unerwünschten säulenförmigen Schichtstruktur durch die Nitridbildung bei Hochdosis-Stickstoffimplantation.
Amorphe Schichten bilden sich im Falle von Ta(Si) bereits beim Abscheiden durch Sputtern. In solchen Systemen wird durch Implantation von Stickstoff oder Sauerstoff die thermische Stabilität des amorphen Zustandes erhöht (siehe Abb.2). Reines Ta(Si) kristallisiert bereits bei 650°C, während eine sauerstoffimplantierte Schicht bei dieser Temperung noch amorph bleibt. Durch eine Stickstoffimplantation läßt sich der amorphe Zustand auch noch bei 800°C erhalten.
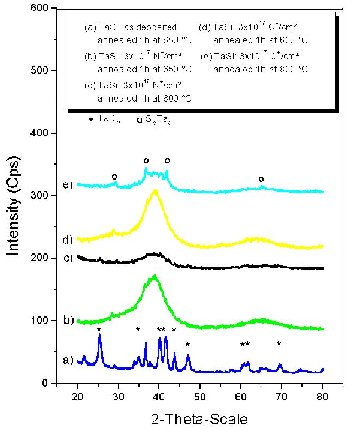 |
Abb.2: Röntgenbeugungsdiagramme von 100 nm Ta(Si)-Schichten, die die Erhöhung der thermischen Stabilität des amorphen Zustandes zeigen: (a) reines Ta(Si) - rekristallisiert nach 650°C/1h, (b) + (c) durch Implantation von 3x1017 N+/cm2 (65 keV) amorph bis 800°C, (d) + (e) nach Implantation von 3x1017 O+/cm2 (70 keV) amorph bis 650°C und rekristallisiert nach 800°C. |
Einen anderen Weg zur Verbesserung der Barriereeigenschaften bietet das Ionenstrahlmischen der Grenzschicht Ta/Cu. Durch Implantation von 1x1016 Cu+/cm2 in die Grenze von 50 nm Ta auf Cu bildet sich eine etwa 5 nm breite amorphe Zwischenschicht.Diese reduziert das Eindringen von Cu in die Ta-Schicht während einer Temperung bei 650°C sehr stark, wie Abb.3 zeigt.
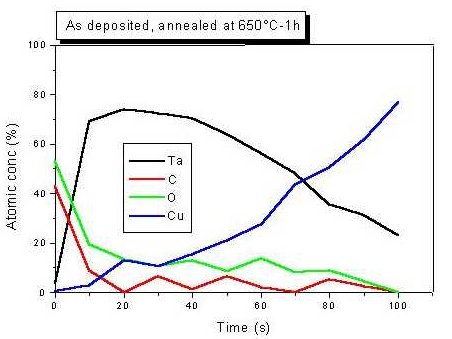 |
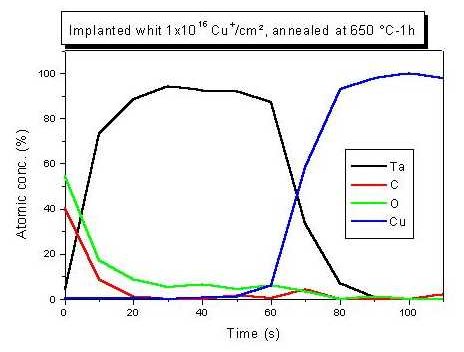 |
|
(a) AES Spektren des unbehandelten Materials - Eindringen von Cu in die Ta-Schicht,
|
(b) AES Spektren mit ionenestrahlgemischter Grenzfläche - kein Eindringen von Cu nachweisbar
|
Diese Arbeit wird durch das Sächsiche Staatsministerium für Wissenschaft und Kunst (SMWK) gefördert und ist Gegenstand einer Kooperation mit der TU Desden, Institut für Halbleiter- und Mikrosystemtechnik und dem FhG Institut für Zerstörungsfreie Prüfverfahren Dresden (EAQD).

