Hochenergie-Ionenimplantation
 Die Hochenergie-Ionenimplantation hat in der Fertigungstechnologie einer Reihe von Halbleiter-Bauelementen bereits große Verbreitung gefunden. Genutzt werden die bekannten Vorteile bei der gezielten Einbringung von Dotier- Atomen, der Erzeugung von Defekten oder der Kombination beider Wirkungen.
Die Hochenergie-Ionenimplantation hat in der Fertigungstechnologie einer Reihe von Halbleiter-Bauelementen bereits große Verbreitung gefunden. Genutzt werden die bekannten Vorteile bei der gezielten Einbringung von Dotier- Atomen, der Erzeugung von Defekten oder der Kombination beider Wirkungen.
Die hohe Ionenenergie von typischerweise einigen Megaelektronenvolt (MeV) bewirkt eine große Eindringtiefe der Ionen im Material. Dadurch lassen sich u.a. vergrabene Dotanden- und Defektprofile erzeugen, was durch kein anderes Verfahren möglich ist.
Die geringen Dosiswerte von 1010 bis 1013 cm-2 der Hochenergie-Ionenimplantation machen das Verfahren auch wirtschaftlich attraktiv.
Typische Anwendungsgebiete der Hochenergie-Ionenimplantation sind
- Implantation leichter Ionen (H, He) in Halbleiterbauelemente der Leistungselektronik (Leistungsdioden, Thyristoren, oder Power- MOSFETs) zur Verbesserung des Schaltverhaltens
- Implantation dotierender Elemente (H, B, P, As etc.) zur Beeinflussung der Feldstärkeverteilung in Photodioden, Teilchendetektoren oder Hochspannungs-Bauelementen
- Implantation schwerer Ionen zur Verbesserung der Emissionscharakteristik von Laserdioden.
Folgende Implantationskammern und Waferhandlingsystem stehen für die Hochenergie-Ionenimplantation an unseren 6 MV Tandetron und 3 MV Tandetron Hochenergie-Ionenbeschleunigern zur Verfügung.
6 MV Tandetron
|
|
High Voltage Engineering Europa B.V. |
|
|
Duoplasmatron Model 358 + Li-Umladekanal (nur für He-) Cs-Sutterquelle Model 860C |
|
|
0,3 - 6 MV |
|
|
0,6 - 50 MeV (abhängig vom Ladungszustand des Ions) |
(I) Kanal 3: Einscheiben Implantationskammer
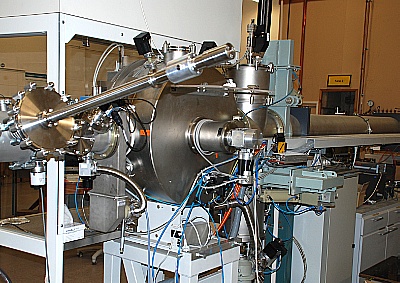 |
|
|
x, y elektrostatisch (f ≈ 1 kHz) |
|
|
Wafer oder planare Proben |
|
|
bis zu 150 mm Wafer |
|
|
7° (andere auf Nachfrage) |
|
|
ungekühlt, typischerweise Raumtemperatur |
|
|
ab 1x1010 cm-2 |
|
|
Klasse 6 (DIN EN ISO 14644) |
|
|
typisch: 20 Wafer/h, fluenzabhängig |
|
(II) Kanal B2: Waferhandler
 |
|
|
≤ 150 mm: x, y elektrostatisch, >150mm, Kombination elektrostatisch/ mechanisch |
|
|
ausschließlich Wafer |
|
|
bis 200 mm Wafer |
|
|
7° (andere auf Nachfrage) |
|
|
ungekühlt, typischerweise Raumtemperatur |
|
|
ab 1010 cm-2 |
|
|
Klasse 5 (DIN EN ISO 14644) |
|
|
bis 50 Wafer/h, fluenzabhängig |
|
3 MV Tandetron
|
|
High Voltage Engineering Europa B.V. |
|
|
Cs sputter ion source IONEX 860-C |
|
|
0,1 - 3 MV |
|
|
0,2 - 8 MeV (abhängig vom Ladungszustand des Ions) |
(I) Kanal 2: Einscheiben große Implantationskammer
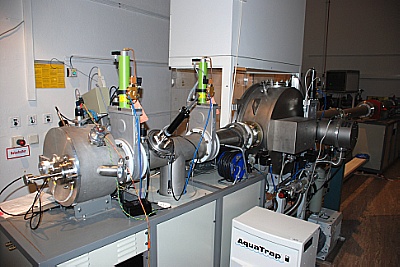 |
|
|
x, y elektrostatisch (f ≈ 1 kHz) |
|
|
Wafer |
|
|
bis 125 mm Wafer |
|
|
7° Standard |
|
|
ungekühlt, typischerweise Raumtemperatur |
|
|
ab 5x1010 cm-2 |
|
|
Klasse 5 (DIN EN ISO 14644) |
|
|
typisch: 20 Wafer/h, fluenzabhängig |
|
(II) Kanal 2: Einscheiben kleine Implantationskammer
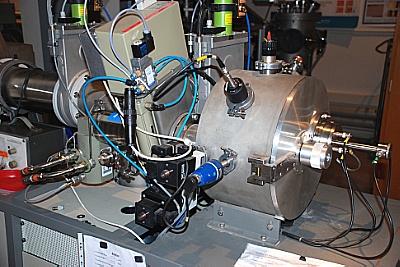 |
|
|
x, y elektrostatisch (f ≈ 1 kHz) |
|
|
Wafer |
|
|
bis 100 mm Wafer |
|
|
7° oder 0° |
|
|
von LN2 bis 800°C |
|
|
ab 5x1010 cm-2 |
|
|
nicht überwacht |
|
|
typisch: 10 Wafer/h, fluenzabhängig |
|
(III) Kanal 4: Halbautomatischer Waferhandler EATON NV-10
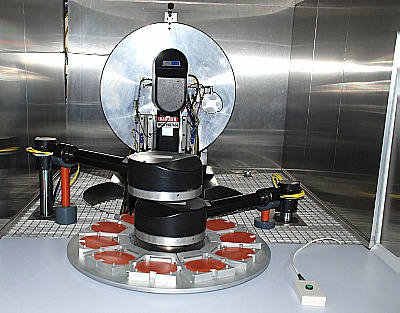 |
|
|
x, y (mechanisch) |
|
|
Wafer |
|
|
100 mm, 125 mm und 150 mm Wafer |
|
|
7° |
|
|
ungekühlt, typischerweise Raumtemperatur |
|
|
ab 1012 cm-2 |
|
|
Klasse 5 (DIN EN ISO 14644) |
|
|
bis 100 Wafer/ h |
|
Die Hochenergie-Ionenimplantation hat in der Fertigungstechnologie einer Reihe von Halbleiter-Bauelementen bereits große Verbreitung gefunden. Genutzt werden die bekannten Vorteile bei der gezielten Einbringung von Dotier- Atomen, der Erzeugung von Defekten oder der Kombination beider Wirkungen.


